2025.09.03 レゾナック、新連合「JOINT3」設立 国内外27社でチップレット関連技術を開発
参画企業全27社から関係者が集った。中央下が髙橋社長
レゾナックは3日、国内外の半導体材料・装置・設計企業による次世代半導体パッケージに関するコンソーシアム「JOINT(ジョイント)3」を設立したと発表した。半導体製造後工程の高度化に向けて期待される「2.xDパッケージ」向け中間基板として、新たな材料や製造方法を採用した「パネルレベル有機インターポーザー」に関する共同開発を推進。総事業費260億円の5年間のプロジェクトで、東京エレクトロンやキヤノン、AGCなど、27社が参画する。
今回のコンソーシアムは、同社がこれまで主導してきた「JOINT2」を発展させた連携組織。新エネルギー・産業技術総合開発機構(NEDO)の助成事業として活動してきたが、今回から民間企業のみになる。
対象領域に合わせ、材料や製造装置だけでなく計測や設計にかかわる企業も参画。日系企業のほか、4カ国からグローバル企業も集った。今回が最多の参画社数となる。

レゾナックの下館事業所(茨城県結城市)に活動拠点「APLIC」を開設。そこに構築した独自の試作ラインを来年末を目安に稼働させ、各社の開発に生かす。
都内で行われた会見で、同社の髙橋秀仁社長は「半導体製造装置・材料・設計企業が強みやノウハウ結集し補完関係を築きたい」と意気込んだ。
2.xDパッケージとは、複数のチップを1パッケージに収めるチップレットなどのために活用される。縦型にチップを積み上げ3次元方向にパッケージすることで高集積化でき、異なる種類のチップを後工程でまとめることもできる。ここで、チップ同士をつなぐ中間基板がインターポーザーだ。
インターポーザーはこれまでSi(ケイ素)を材料としてきたが、半導体の性能向上に伴う大型化で感光性絶縁材料や封止材といった有機樹脂を用いたものへの移行が進んでいる。その製法は円形のウエハーから四角片を切り出す仕組みだったが、大型化によりウエハー当たりの取り数の減少が課題となっている。そこで、四角いパネル状に変更することで、無駄なくインターポーザーを取り出せる製法が注目されていた。
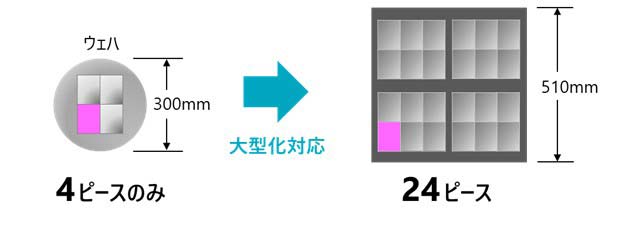
APLICの試作ラインでは、515×510ミリメートルサイズのパネルを製造する。パネルの大型化に伴い生じる「位置合わせ精度」や「反りの増大」「面内均一性の確保」といった課題を解決するため、実証を重ねる。